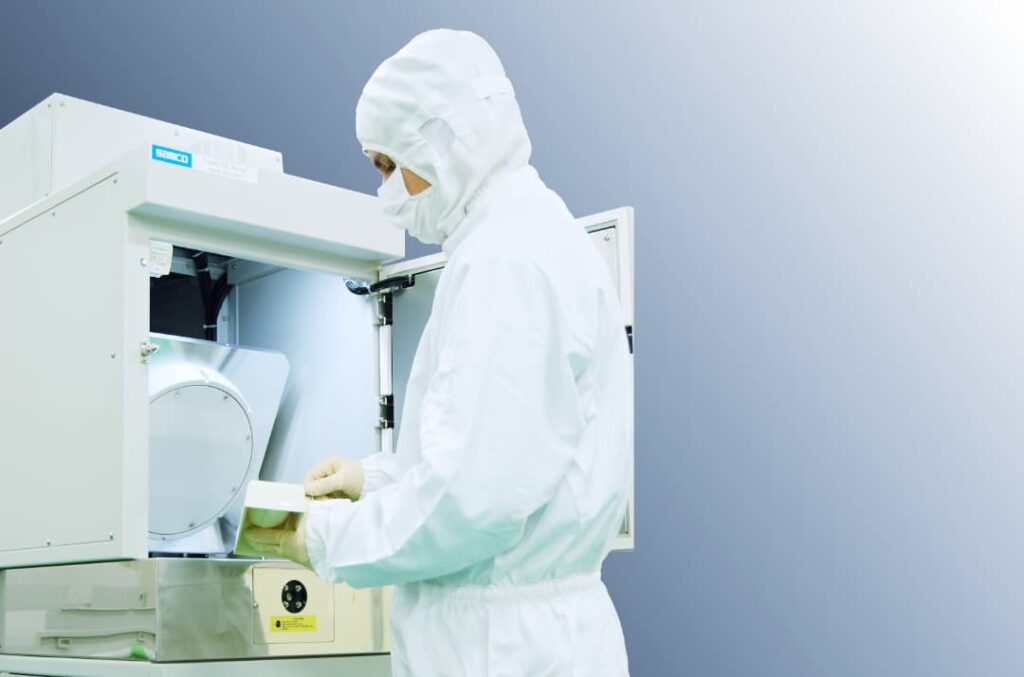
Plasma Enhanced Chemical Vapor Deposition (PECVD) is a technology which forms a thin film by generating active radicals and ions on a target substrate by turning a reactive gas into a plasma state and causing chemical reactions on the target substrate to be deposited. It is used to deposit silicon nitride film (SiN) as a passivation film and silicon oxide film (SiO₂) as an interlayer insulating film in the manufacturing process of compound semiconductors and silicon semiconductors.
The PD-220NL is a compact anode-type plasma CVD system optimized for R&D and pilot production. It offers superior film control and stable plasma characteristics in a space-saving design, making it ideal for universities, research institutes, and prototype fabrication lines.
Anode PECVD System Lineup
Anode-Coupled PECVD: Precision Deposition for Sensitive Devices
In our PECVD (Plasma Enhanced Chemical Vapor Deposition) systems, two configurations cater to different device requirements: anode-coupled PECVD and cathode-coupled PECVD.
In an anode-coupled PECVD system, the RF power is applied to the upper electrode, while the substrate rests on the grounded electrode (the anode). The electrical energy generates a plasma, breaking down the gas mixture into radicals, ions, neutral atoms, and molecules. Due to this setup, fewer ions reach the substrate, making anode PECVD ideal for devices sensitive to ion damage. Samco’s anode PECVD systems are optimized for R&D and production, offering precise control over deposition uniformity, film stress, and step coverage. However, the deposition rate tends to be lower (typically around 50 nm/min) due to reduced ion energy.
Our anode PECVD systems ensure high-quality thin film deposition with capabilities tailored to sensitive device applications.
Key Features & Benefits
- Superior deposition uniformity
- Excellent stress control
- Good step coverage




